美国公司推出新型芯片布线技术:可用于 3nm 工艺,大幅减小内阻
来源:IT之家 发布时间: 2021-06-19 10:15:11 编辑:夕歌
导读:据外媒 techpowerup 消息,美国公司 Applied Materials(应用材料公司)宣布了一项新的半导体芯片布线技术,可以用于 3nm 制程工艺,能够大幅减少芯片内阻,从而提高效率,减小发热。
据外媒 techpowerup 消息,美国公司 Applied Materials(应用材料公司)宣布了一项新的半导体芯片布线技术,可以用于 3nm 制程工艺,能够大幅减少芯片内阻,从而提高效率,减小发热。
官方表示,目前芯片多使用通孔在芯片中布线,随着制程提升,这种方式可以使得连接电阻增加 10 倍,从而抵消制程进步带来的优势。
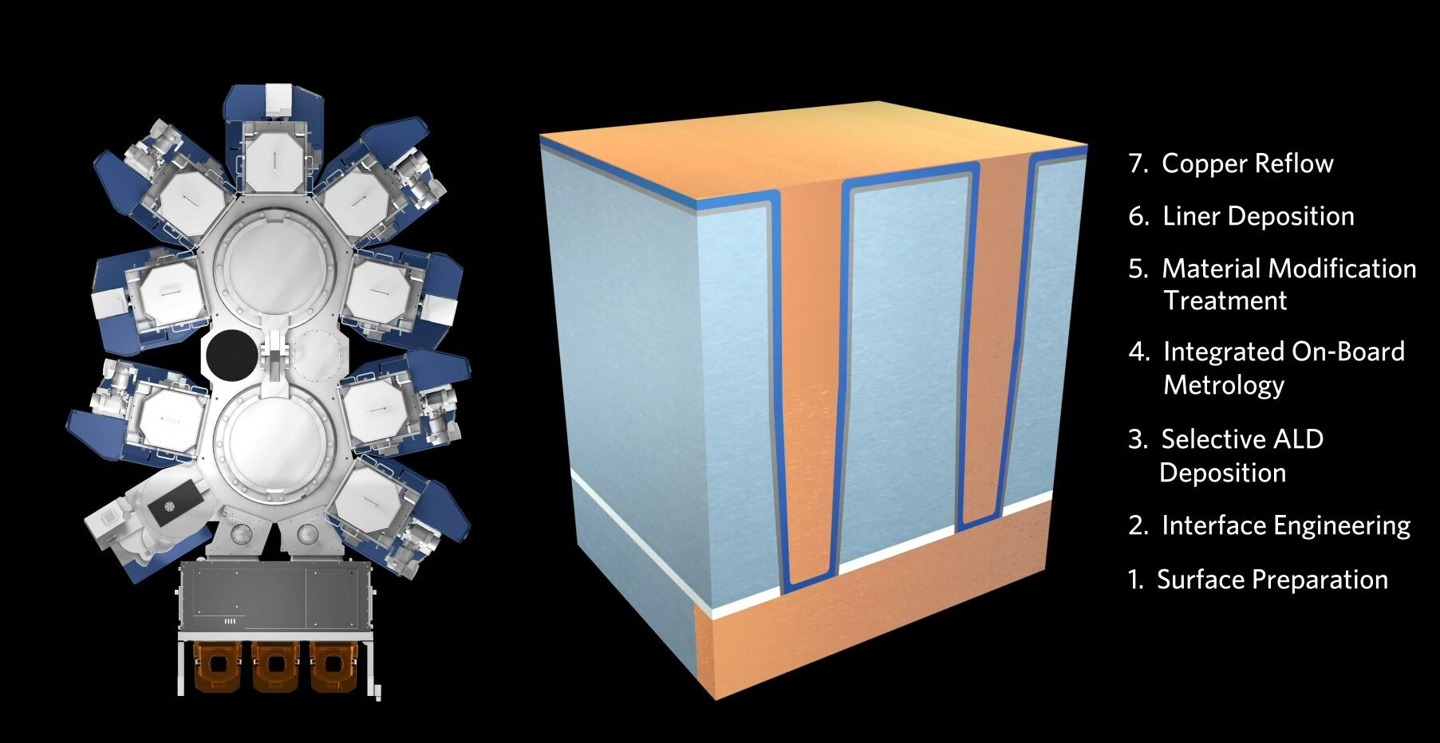
据IT之家了解,新的布线方法名为 Endura Copper Barrier Seed IMS,使用铜材质填充通孔,采用了 7 项工艺和方法来实现。具体方法包括表面处理、定向 ALD 沉积、PVD、 CVD、铜回流等,可以在狭窄的缝隙内填充铜元素,使得电阻降低 50% 以上。
应用材料公司半导体产品部高级副总裁 Prabu Raja 表示,“智能手机芯片具有数百亿条铜连接线,布线的内阻消耗了芯片三分之一功率。这项技术在真空中进行加工,集成多项技术,重新设计材料和结构,可以使得电子产品获得更长的续航时间。”